Deep reactive ion etching of Si-based materials Oxford Instruments Plasma Technology PlasmaPro 100 (DRIE)
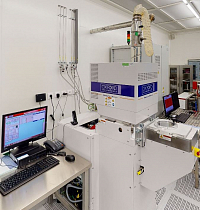
Guarantor:
Marek Eliáš, Ph.D.
Technology / Methodology:
Etching & Deposition
Instrument status:
![]() Operational, 20.7.2021 12:57
Operational, 20.7.2021 12:57
Equipment placement:
CEITEC Nano - C1.34
Research group:
CF: CEITEC Nano
Detailed description:
Deep reactive-ion etching (DRIE) is a highly anisotropic etch process used to create deep penetration, steep-sided holes, and trenches in wafers/substrates, typically with high aspect ratios. It was developed for microelectromechanical systems (MEMS), which require these features, but is also used to excavate trenches for high-density capacitors for DRAM and more recently for creating through silicon via´s (TSV)´s in advanced 3D wafer-level packaging technology.
There are two main technologies for high-rate DRIE: cryogenic and Bosch, although the Bosch process is the only recognized production technique. Both Bosch and cryo processes can fabricate 90° (truly vertical) walls, but often the walls are slightly tapered, e.g. 88° („reentrant“) or 92° („retrograde“).
Another mechanism is sidewall passivation: SiOxFy functional groups (which originate from sulfur hexafluoride and oxygen etch gases) condense on the sidewalls and protect them from lateral etching. As a combination of these processes deep vertical structures can be made.
Publications:
-
LIU, X.; FECKO, P.; FOHLEROVÁ, Z.; PEKÁREK, J.; KARÁSEK, T.; NEUŽIL, P., 2020: Parylene Micropillars Coated with Thermally Grown SiO2. JOURNAL OF VACUUM SCIENCE & TECHNOLOGY B 38(6), p. 38 - 6, doi: 10.1116/6.0000558; FULL TEXT
(SUSS-MA8, SUSS-RCD8, DWL, DRIE, RIE-FLUORINE, PARYLENE, XEF2, APCVD, LYRA) -
GABLECH, I.; KLEMPA, J.; PEKÁREK, J.; VYROUBAL, P.; HRABINA, J.; HOLÁ, M.; KUNZ, J.; BRODSKÝ, J.; NEUŽIL, P., 2020: Simple and efficient AlN-based piezoelectric energy harvesters . MICROMACHINES 11(2), p. 1 - 10, doi: 10.3390/mi11020143; FULL TEXT
(DRIE, RIE-CHLORINE, WIRE-BONDER, KAUFMAN) -
Brodský, J., 2019: Characterization of graphene elecrical properties on MEMS structures. BACHELOR´S THESIS , p. 1 - 50
(MPS150, WITEC-RAMAN, EVAPORATOR, DRIE, PECVD, DWL, SUSS-MA8, RIE-FLUORINE, RIE-CHLORINE, DIENER, SCIA) -
Fecko, P., 2019: Gecko mimicking surfaces. MASTER´S THESIS , p. 1 - 52
(SUSS-RCD8, SUSS-MA8, DWL, DRIE, LYRA, ALD, RIE-FLUORINE, ICON-SPM, PARYLENE, XEF2) -
PRÁŠEK, J.; HOUŠKA, D.; HRDÝ, R.; HUBÁLEK, J.; SCHMID, U., 2019: Optimization of Cryogenic Deep Reactive Ion Etching Process for On-Chip Energy Storage
. INTERNATIONAL SPRING SEMINAR ON ELECTRONICS TECHNOLOGY ISSE , p. 1 - 6, doi: 10.1109/ISSE.2019.8810293; FULL TEXT
(DRIE, ICON-SPM, SUSS-MA8, SUSS-RCD8, EVAPORATOR, DWL)

 CEITEC BUT
CEITEC BUT